Contact :
Hanako Okuno
Le laboratoire LEMMA développe des techniques avancées de microscopie pour l’étude de matériaux 1D et 2D, incluant des matériaux 1D et 2D et les interfaces atomiquement fines. Pour éviter les irradiations dûes au faisceau, de l’imagerie (S)TEM à basse tension est généralement utilisée pour les analyses de matériaux. L’objectif principal est de fournir des informations structurelles et chimiques à l’échelle atomique, grâce à notre expertise en TEM monochromaté, STEM à correction d’aberrations , EDX, EELS et 4D-STEM utilisant deux microscopes à la pointe de la technologie (Titan Ultimate et Titan Themis). Nous travaillons sur diverses problématiques des ùatériaux 1D et 2D, comme la croissance, le contrôle des propriétés des matériaux, dans des collaborations fortes avec d’autres groups de recherché au niveau national comme international.
Main collaborations :
Spintec, L_Sim, Leti, LTM (CNRS), Institut Néel (CRS), IRAMIS (CEA-Saclay), NCSR (Greece), UCL (Belgique)
 Analyse structurelle du graphène (coll. Liten, L-Sim, Institut Néel, INP, IRAMIS)
Analyse structurelle du graphène (coll. Liten, L-Sim, Institut Néel, INP, IRAMIS)
Les défauts structurels sont considérés comme un paramètre levier pour le réglage des propriétés physiques des matériaux 2D. La capacité à créer des défauts atomiques à l’échelle nanométrique ouvre des possibilités pour améliorer ou diminuer les propriétés électriques, optiques, mécaniques et magnétiques. Malgré l’intérêt grandissant dans les matériaux 2D, la croissance de matérieux 2D sans défauts reste difficile, l’indentification et la caractérisation de ces inévitables défauts de croissance intrinsèques reste donc un processus essentiel. Comme le graphène est une couche d’une épaisseur mono-atomique, composée uniqueme,nt d’atomes de carbone légers, l’analyse de structure atomique requiert des conditions microscopiques particulières. Le Titan Ultimate est équipé d’un correcteur d’aberrations et d’un monochromateur, permettant de réaliser de l’imagerie TEM à resolution atomique à 80kV, ainsi qu’à fournir des informations sur les défauts de structure atomique permettant d’étudier la croissance et les propriétés du matériau.
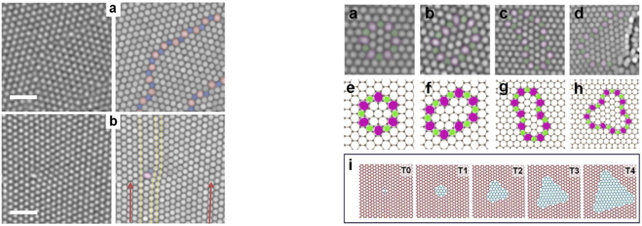
Figures : (gauche) Limite de grain avec 5-7 défauts linéaires et dislocations trouvés dans le graphène CVD, démontrés comme la clé de la recristallisation (A. Tyurnina
et al.,
Carbon 102 p499, 2016) et (droite) défauts floraux observés expérimentalement et structures connexes calculées par DFT, qui sont utilisés pour le concept d'" ingénierie par la conception " (A. Cresti
et al.,
Carbon 161 p259, 2020).
 Croissance de TMD (Transition Metal Dichalcogenides) par épitaxie et leurs hétérostructures Van der Waals (coll. Spintec, NCSR, LTM)
Croissance de TMD (Transition Metal Dichalcogenides) par épitaxie et leurs hétérostructures Van der Waals (coll. Spintec, NCSR, LTM)
Les structures atomiques présentes dans les TMD obtenus par croissance MBE (et autres matériaux associés) peuvent être identifies en utilisant un TEM monochromaté et un STEM à correction d’aberration (Titan Ultimate & Themis). L’imagerie à contraste-Z HAADF fournit la position des atomes, de même que leur attribution élémentaire. Les croissances épitaxialles Van der Waals et quasi-Van der Waals sont étudiées soit en vue planaire soit en analyse cross-section, donnant des informations sur les corrélations de structures locales entre matériaux d’un même stack. De nouvelles methodes d’imagerie 4D-STEM permettent de carthographier l’orientation et la phase dans des monocouches 2D obtenues par croissance épitaxique. Ces techniques sont combinées avec d’autres méthodes d’analyse (XRD, AFM, XPS, STM) pour étudier les mécanismes de croissance et pour explorer de nouvelles fonctionaliés pour les matériaux, en forte collaboration avec les équipes matériaux. De l’observation
in-situ (sous irradiation électronique et/ou à haute températures) est également utilisée pour étudier les dynamiques de modification structurelles.

Figures : (gauche) Défaut typique trouvé dans le MoSe2 cultivé par MBE, déterminé par imagerie TEM monochromatique. Les domaines d'inversion sont formés en raison de la carence en Se induite pendant le processus de croissance (C. Alvarez
et al.,
Nanotechnology 29 p425706, 2018) et (droite) Image STEM en coupe transversale de Fe5GeTe2 ; la position de l'atome complexe de Fe a été déterminée par comparaison avec l'image simulée (M. Ribeiro
et al., 2D Materials and Applications 6, p1, 2022).
 Analyse chimique de couches atomiquement fines
Analyse chimique de couches atomiquement fines
L’identifaiction chimique locale dans des couches 2D peut être réalisée à travers deux techniques différentes. L’imagerie à contraste-Z HAADF donne un contraste chimique quantitatif. Les impuretés comme les dopants et/ou des éléments appartenant à des hétérostructures sont déterminées localement en comparant les profils d’intensité dans les images obtenues expérimentalment et les images simulées. Puisque le profil d’intensité est sensiblement impacté par des aberrations résiduelles et du tilt d’échantilon, des praramètres d’observations parfaits sont requis pour une analyse chimique fiable. La spectroscopie EELS est également utilsée pour une détermination élémentale directe, cependant cette technique requiert un long temps d’acquisition pour corriger assez de signaux et une preparation spéciale de l’échantillon est généralement requise, comme des surfaces extrêmement propres et/ou une couche de protection en graphène pour une analyse non-destructive à 80kV.

Figures : Identification du dopant atomique unique vanadium intégré par substitution dans le site W de la monocouche WSe2 (P. Mallet
et al.,
Physical Review letters, 125, p036802, 2020) par différentes techniques de microscopie ; (à gauche) imagerie quantitative à contraste Z et (à droite) imagerie spectrale à résolution atomique EELS.
 Carthographie des champs électriques à échelle atomique par Centre de Masse (CoM) (coll. Institut Néel, UC Louvain)
Carthographie des champs électriques à échelle atomique par Centre de Masse (CoM) (coll. Institut Néel, UC Louvain)
Nous développons au laboratoire actuellement plusieurs techniques 4D-STEM. Un balayage de trame d’une sonde d’électron focalisée est passé sur l’échantillon, et un pattern de diffraction est acquis pour chaque position de la sonde. La presence d’un champ (électrique) dans l’échantillon résulte dans la déflexion du faisceau transmis, une analyse minutieuse de la position du faisceau transmis peut conduire aux champs électrique avec une resolution spatiale atomique en utilisant les équations de Poisson, avec la densité de charge et le potentiel électrostatique. En utilisant du STEM à basse tension et correction d’aberrations, en conjonction avec une caméra rapide, on peut faire une carthographie des champs électriques dans une monocouche 2D, en mesurant le centre de masse (Center of Mass, CoM) dans le faisceau transmis. Cette techniques est en développement dans le but de mieux comprendre les charges locales induites par des défauts dans les structures 2D, comme dans des échantillons dopes ou des échantillons Moiré.
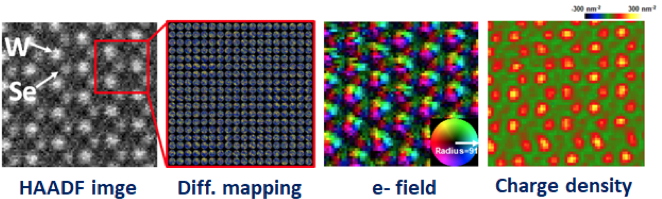
Figures : Image HAADF d'une monocouche de WSe2 (matériau 2D), cartes de champ électrique local et de densité de charge calculées à partir de la déviation du faisceau transmis (en cours de thèse de K. Sharma et D. Desenovic).
 Analyse d’interface (coll. NPSC, LTM, Spintec)
Analyse d’interface (coll. NPSC, LTM, Spintec)
Les échantillons Cross-section préparés avec une technologie FIB (Focused Ion Beam) permettent d’observer et de faire l’analyse de l’interface entre les différentes couches d’échantillons stackés, comme les couches fines d’hétérostructures van der Walls. L’étude du phénomène prenant place à l’interface entre les couches, comme l’insertion, la diffusion, le mélange (intermixing?) ou l’évolution de l’état des liaisons chimiques sont possibles en combinant imagerie (S)TEM et spectroscopie.

Figures : (gauche) Couche métallique d'indium 2D formée sous la couche de graphène
via l'intercalation entre la couche tampon et le substrat SiC (N. Feldberg
et al.,
Nanotechnology 30, p375602, 2019) et (droite) évolution de l'état d'oxydation du Ti dans la surface extrême du STO à l'interface avec l'Al, suivie de l'imagerie du spectre EELS. (DC Vaz
et al.,
Nature Materials 18, p1187, 2019).